- 製品名やキーワードで検索
- お電話でのお問い合わせはこちら
-
東京03-5379-0051 大阪06-6212-2500
名古屋052-686-4794 仙台022-218-0560
- 製品名やキーワードで検索
東京03-5379-0051 大阪06-6212-2500
名古屋052-686-4794 仙台022-218-0560


別途、液中チャンバーをご用意いただくことで溶液中での測定にも対応します。左図は、カチオンとアニオンのデキストランを交互に堆積する様子を計測した事例です。
金基板上にカチオンのデキストランを堆積し、水でリンスすると膜厚が小さくなり(20分~),さらにアニオンのデキストランが堆積していく(50分付近空)様子をリアルタイムに計測することが可能です。
有機発光ダイオード(OLED) をはじめとする有機EL は、ディスプレイや照明への実用化が進んでおります。その発光層およびその周辺部分の材料選択や膜厚調整により、デバイスの性能に影響されるため、膜厚を正確にかつ高精度に計測することが求められています。
下記はOLED 膜の膜厚を計測した事例です。
FS-1 では、膜厚と薄膜の光学定数を同時に求めることが出来るため、コートされたOLED 膜の高精度膜厚計測と光学定数による膜の評価
が可能になります。
また、オプションのin situ アダプタを使用することで真空蒸着中のOLED 膜の膜厚や光学定数変化を直接モニタリングすることが可能です。
OLED フィルムの解析モデルは、下記に示すように、各波長でのフィルムの屈折率をフィッティングすることにより、Fit Diff の大幅な低減が得られました。 信頼性を示す、Fit Diff 値( 低いほど良い) は0.0007 と非常に小さく抑えられております。 また解析モデルに消衰係数(k) を追加しても、データは大幅には改善されませんでした。 これは測定した膜にFS-1 測定波長でフィルムに吸収がないことを示しています。

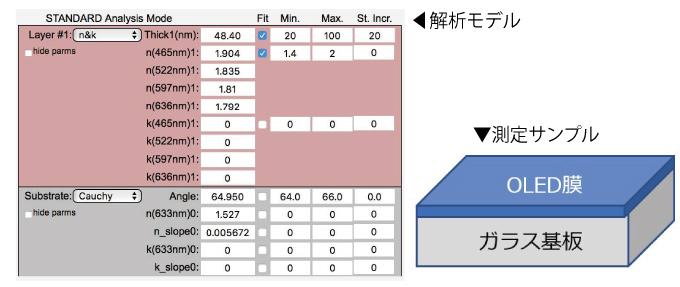
| サンプル | 代表的なアプリケーション |
|---|---|
| 半導体 | シリコンの酸化物や窒化物、High-k及びLow-k誘電体、 アモルファスシリコン膜および多結晶シリコン膜、フォトレジスト |
| 光学コーティング | SiO2, TiO2, Ta2O5, MgF2などの高/低屈折率の薄膜 |
| ディスプレイ | TCO(ITOなど)、アモルファスシリコン膜、有機膜(OLED技術向け) |
| 記憶媒体 | ダイヤモンドライクカーボン(DLC)膜 |
| R & Dプロセス | in situ測定による蒸着薄膜評価(蒸着率と光学定数)とプロセスコンディションの比較 MBEやMOCVD、ALD、スパッタリングなどへの応用可能 |
| 化学及び生物学 | サブモノレイヤー分子の吸着 |
| 工業 | インライン・モニタリングおよび膜厚制御 |
| 金属酸化膜 | Al2O3, Cu2O, CuO, MgO, TiO2等 |
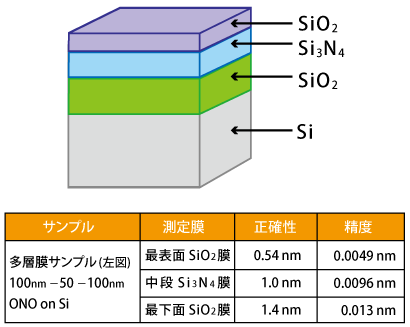
FS-1では多層膜サンプルの計測も可能です。
左の測定事例のように、2層以上の薄膜でも正確に、また高精度でその膜厚を明らかにすることが出来ます。
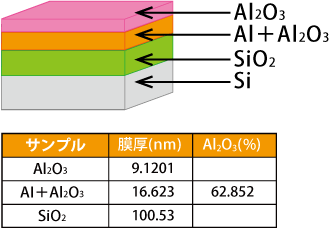
金属薄膜の光学定数は蒸着時の間隙などに依存されます。酸化アルミ(Al2O3)についても同様に酸化されていないAlが混在した層が形成されることがあります。
FS-1ではこのような混合層もしくは間隙を含む薄膜においても、混合比率を考慮して高精度に各層の膜厚を求めることが可能です。
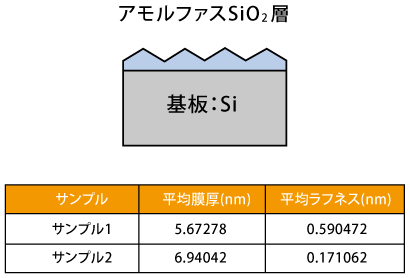
左図のサンプルはSi基板をアトムビームエッチングした際に生じるダメージ層(アモルファスシリコン)の膜厚を測定した事例です。エリプソメトリーの測定結果は、表面ラフネスに影響されます。
FS-1ではエッチング時のラフネスの増加を考慮した光学モデルから高精度の膜厚を計測することが可能です。
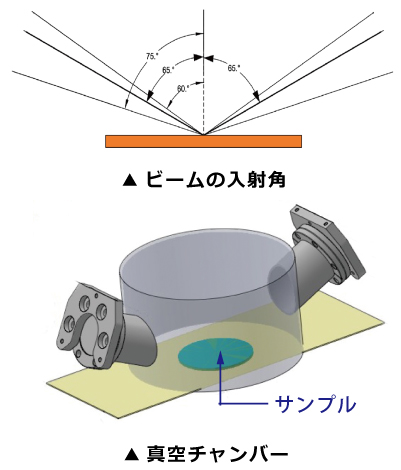
特許取得の新MWE技術では光学経路は固定されており、装置内部に可動部位がありません。このため、InSitu取付やその後の校正も簡単に行うことができます。LED光源を採用することで装置が非常にコンパクトになり、真空装置や真空装置に取付けられた他の検出器と干渉することも最小限に抑えることが可能です。また、FS-APIインターフェース(LabVIEW™ 互換性あり)で外部ソフトウェア制御ができます。
● ビームの入射角は標準で 65°、60°- 75° までは対応可能
● ビーム全長は最大で1mまで対応可能
真空装置は、FS-1 マルチスペクトル・エリプソメーターを取付ける入射光と反射光が通るウインドウが2つ必要です。ウインドウは、ビームの入射角度が65°になる位置が望ましいのですが、60°~75°までなら対応可能です。
また、FS-1の光源から検出器までの距離(ビーム全長)は、最大1mまで対応可能です。ビーム全長とスポットサイズ(測定エリア)は下記の通りです。下記表より小さいサンプルに対応したアダプターも用意しております。

原子層堆積装置(ALD)は、化学反応による成膜方法で、原子一層の成膜を行う装置です。
FS-1は原子一層レベル(オングストローム領域)の膜厚変化を高精度に測定することができます。また高速(10m秒間隔)でデータ取得が可能なため、ALDサイクルによる膜厚の増減や初期サイクルにおける膜厚増加を定量化できます。

● ALDを使用したルテニウム堆積膜 (Ru(EtCP)2 + O2プラズマ)のin situ測定
● Seed層となる白金(Pt)を、ALDにより20, 35, 70サイクルで堆積した際の膜厚変化です。(上左図)
白金膜の膜厚の再現性は非常に高いことが分かります。
● 異なる膜厚の白金 Seed層上にALDでRuを堆積した際のRu膜の膜厚変化です(上右図)
<ALD 搭載事例>
Kurt J. Lesker社(モデルALD 150LX)、Lam Research社、Picosun社、Beneq社、Ultratech社、その他カスタムALDチャンバー

上のグラフは、スパッタコーター(Kurt J. Lesker社 PVD75)によるチタン薄膜の堆積時の膜厚を計測した事例です。 オングストロームレベルの非常に薄い薄膜も高い精度で測定することが可能です。

上のグラフは、チタン(Ti)の初期堆積を2つの方法で解析した結果です。グラフの左のy軸が膜厚をnmで表し、右のy軸が解析の信頼性をFitDiffで表したものです。このFitDiffは値が小さいほど信頼性が高くなります。
解析①の「膜厚のみを解析したモデル」では堆積直後に大きくなっていますが、解析②の「膜厚とラフネスを同時に解析したモデル」の方が、全体的に値が低く、膜厚と同時にラフネスを解析した方が信頼性が高いことを表しています。
このことから膜厚とラフネスの両方が変化していると考えられます。つまり、Ti膜ができるのではく、最初にTiの核が形成されてラフネスが上昇し、その後にTi膜が形成されていることを示しています。
FS-1では、このようなラフネスを考慮した解析も可能です。
資料御提供:Penn St. University Materials Research Inst., William Drawl
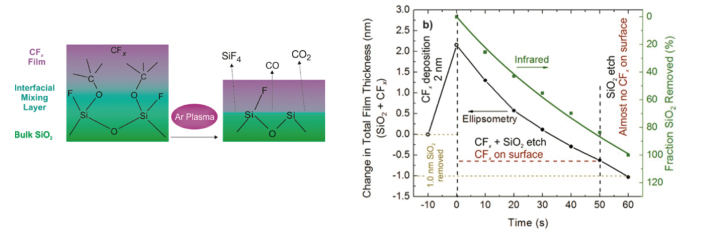
ALEでは、まずSiO2上にフルオロカーボンを堆積させます。この際、CF層とその下のSiO2膜との間に原子的に薄い混合層が形成されます。その後にアルゴンプラズマを行うとCF層と共に下地のSiO2層が同時に除去されます。
右のグラフでは、黒線がエリプソメトリーによって測定されたCF層とSiO2がエッチングされた膜厚、緑色の線がSiO2の含有量を示しています。FS-1の測定でCF層の除去と同時に下地のSiO2層が1nm程度エッチングされていることが分かります。
参考文献:
Ryan Gasvoda et. al., “Surface Phenomena During Plasma-Assisted Atomic Layer Etching of SiO2”, ACSAppl. Mater. Interfaces, 2017, 9 (36), pp 31067–31075
資料請求などもこちらからどうぞ。お気軽にお問い合わせください。
資料請求などもこちらからどうぞ。
お気軽にお問い合わせください。